CSE晶圓級封裝化學鎳鈀金
發布時間:
2022-05-25
在微(wēi)電子產品封裝領域,通過使用化學鎳鈀金或Ni-Pd-Au技術,在半導體晶片的I/O金屬(shǔ)鋁或銅焊盤上沉積(jī)可(kě)焊接的Ni-Au或Ni-Pd-Au層。作為凸(tū)點封(fēng)裝中的(de)UBM層(céng)或傳統WB技術中的OPM層,已(yǐ)經(jīng)有了很多的研究和應用。
在微電子產品(pǐn)封裝(zhuāng)領域,通過使用化學鎳鈀金(jīn)或(huò)Ni-Pd-Au技術,在(zài)半導體晶片(piàn)的I/O金屬鋁或銅焊(hàn)盤上(shàng)沉(chén)積可焊接(jiē)的Ni-Au或Ni-Pd-Au層。作為凸點封裝(zhuāng)中的UBM層或傳統WB技術中的OPM層,已經有了很多的研究和應用。
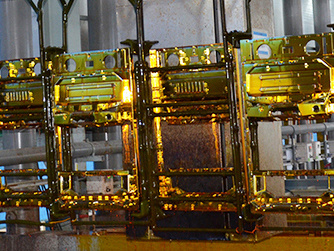
半導體晶片上化學鎳(niè)鈀(bǎ)金的製備有其(qí)特殊性:1、I/O電極材料多為(wéi)鋁合金(jīn),而且不同的晶圓廠,不同的生產工藝,鋁(lǚ)層的成分和質量差別很大。2、I/O電(diàn)極的金屬(shǔ)層很薄,大部分IC產品都在1um左右。3、I/O電極金屬焊盤的麵積有大(dà)有(yǒu)小,在某些產品中變(biàn)化很大,從幾十微米到幾千微米不等。4、由於器件的用途和功能不同,其內部電路設計(jì)差異很大,有些器件在特定的I/O電極上表現出不同的電位。剛開始對這種工藝(yì)技術的理解不是很深,這種(zhǒng)工(gōng)藝技術的控製難度高,會導致批次問題(tí),造成很大的損失。隨著對這項技術認識的深入,包括醫學係統和設備(bèi)的巨大(dà)進步,這項技術已經逐漸廣泛應用於半導體晶片領域。對於某些產品來說,這種工(gōng)藝表現出了更(gèng)好的優勢,比(bǐ)如MOSFET和IGBT,在業界已經量產應用。與其他工(gōng)藝相比(bǐ),化學鎳鈀金(jīn)工藝在質量和成本上的優勢明顯,預計其應(yīng)用範圍的深度和廣度將進一步增加。
在批量(liàng)生產和應用(yòng)中(zhōng),化學(xué)鎳鈀(bǎ)金(jīn)技術顯示了其優勢,但也暴露出一些相(xiàng)應的問題和不足(zú)。晶圓化學鍍是一個複雜的反應,導致產品缺點的因素很多,但大致可以分為兩類:晶圓產品結構和功能造成的(de)缺點和化學鍍(dù)工藝(yì)控製不到位造成的缺點。在產品設計和工程評估階段,首先要對來料(liào)晶(jīng)圓產品(pǐn)2的結構、功能、成(chéng)分、外觀等因素有充分的了解,根據來料輸入的信息對化學鍍後的結果做出更準確的(de)判斷,並(bìng)據此確定(dìng)工藝步驟和措施。根據多年的產品(pǐn)設計和生產經驗,重(chóng)點總結了與產品結構和功能直接相關的(de)化學鍍鎳/鎳鈀鍍層的缺點,並分析了相應缺點產生的原因,這些影響因素應在新產品設計和工程評價階段綜合考慮。
半導體晶片化學鎳鈀金工藝屬於濕法工藝,在(zài)整個過程中,晶片浸泡在含(hán)有強(qiáng)酸和強堿的化學溶液(yè)中(zhōng)。同時,化學鎳浴的反應溫度通常接近(jìn)90度,因此(cǐ)工藝條件相對於(yú)其他後期封裝工藝較為苛(kē)刻(kè)。晶圓生產過程中(zhōng)任(rèn)何細微的差異或(huò)缺點,在其他封裝過程中可以忽略,如針孔、微裂紋等會在化學鍍濕製程後顯露出來。
更多資訊
在線留(liú)言








